与集成电路(IC)商业化生产有联系的关键需求是,了解IC制造中极其重要的化学机械平坦化(CMP)过程中发生的分子相互作用。作为CMP基础的主要分子过程之一涉及散布在水样研磨液中的金属氧化物磨料粒子对添加剂的吸附。在金属氧化物(例如,二氧化硅)上的这种吸附现象是众所周知的包括氢键合、静电作用和范德瓦耳斯力相互作用的产物。添加剂的吸附在数量上受溶液中被吸附添加剂分子和自由添加剂分子间的热动力学平衡支配。在CMP研磨液中,研磨粒子表面处添加剂分子的不断吸附和解吸能用平衡吸附常数量化。确定CMP磨料中粘合添加剂的磨料粒子和自由添加剂二者的浓度,就能用实验确定平衡吸附常数。描述了单分子光谱法、荧光相关光谱(FCS)用于定量分析在CMP磨料上的添加剂吸附。讨论了FCS分析胶态二氧化硅磨料上添加剂吸附有代表性的例子。此外,用 FCS为添加剂吸附与胶态二氧化硅磨料粒子综合体化学组分依从关系的定性。这些发现确立了FCS能实际用作广泛用于商业化CMP工艺的二氧化硅磨料粒子表面化学组成定性的探针。
实验 材料 Alexa fluor 546羧酸琥珀酰亚胺酯 (纯度>95%)购自Life Technologies (Grand Island, NY),胶态二氧化硅样品承蒙Inter Corporation提供。所用的全部其他化学品均是试剂级或试剂级以上的。
荧光相关光谱(FCS) FCS实验采用基于Zeiss Axiovert Model 200共聚焦荧光显微镜的定制系统进行,该显微镜适用于来自样品混合物中荧光物质的激发和聚光发射光。该系统用2mW He-Ne激光(543nm)作为激发源。激发光首先直接通过光束扩展透镜,然后通过装备FT560 双色镜和564-640带通发射体滤波器的反射镜组件。光束扩展器保证了激发光稍微没有充满直接置于样品下面的Zeiss Plan- Apochromat油浸透镜(1.4 NA,放大倍数100)的背光阑。在物镜背光阑入口处测得的入射激光功率约为20 mW。样品发出的荧光用显微镜物镜收集,传送通过分色镜和发射体滤波器,再聚焦到PD5CTC型单光子雪崩二极管(SPAD)检测器的50μm针孔上。用高数值显微镜物镜结合共焦针孔造成约1毫微微升的检测体积,实现单分子检测。检测体积限制了其中容纳的分子数,平均来说,任一时间只有一种。制备染色磨料溶液是将0.5和30 wt%二氧化硅的pH-调节的磨料溶液与1.7 nM Alexa fluor 546 (A546)混合,接着平衡约5分钟。然后把pH-调节的添加剂溶液加入到上述溶液里,充分混合。得到的样品溶液的添加剂浓度为1wt%(假使添加乙氨酸),添加的BTA浓度为0. 1wt%。用于每一样品的溶液总体积是40μL。用HCl或KOH将全部溶液的pH值调节到2,4,6,8。仅含A546的参考溶液用来标定仪器的检测体积参数。对每一添加剂制备添加剂-A546控制溶液,以确定添加剂和A546是否互相作用。全部样品测量时的取样频率是100 kHz,在50秒获取时间内做三次。
结果与讨论 用FCS定量分析染料吸收 FCS 常常通过评估溶液中荧光探针的平动扩散系数(translation diffusion coefficient)来分析小分子粘合到较大物体。标记方法常用于此目的。例如,若用吸附的荧光染料给大分子或悬浮粒子做标记,就能评估溶液中大分子或悬浮粒子的扩散系数。当小分子粘附于已标记的分子或粒子并取代吸附的染料时,未粘附染料的浓度大大增加。根据样品溶液荧光强度起伏的自相关分析,粘附染料与自由(未粘附)染料间平动扩散系数的巨大差异就能定量确定粘附和未粘附荧光染料分子的浓度。
很容易观察到A546在散布的二氧化硅磨料粒子上的吸附(见图1)。对于A546来说,向自相关函数G(τ)的较长相关时间(τ)的偏移反映了二氧化硅粒子上的染料吸附。计算出对应粘附A546粒子和自由粒子(未粘附A546)的扩散系数,在图1给出。无胶态二氧化硅时,单组分拟合足以为A546提供扩散系数。对于A546和胶态二氧化硅混合磨料,二组分拟合对决定粘附A546粒子和自由(未粘附)A546粒子的组成是必要的,图1总结了这些情况。
胶态二氧化硅上苯并三唑(BTA)和乙氨酸吸附分析 苯并三唑(BTA)加入A546-二氧化硅溶液后,它替代约 20%的表面粘附A546二氧化硅粒子,见图2(左)。这一效应在pH值2-8范围内保持不变,说明BTA吸附到二氧化硅表面的机理与pH值无关。与 BTA的吸附不同,A546粘附到二氧化硅粒子的浓度在有乙氨酸存在时会增加,见图2(右)。粘附A546的增加与pH值有关。这很可能是由于在pH值大于2.34时形成乙氨酸两性离子,以及二氧化硅粒子表面的质子化。
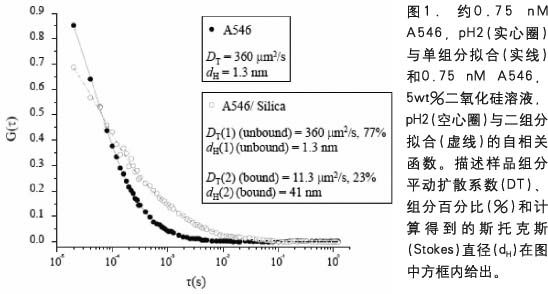
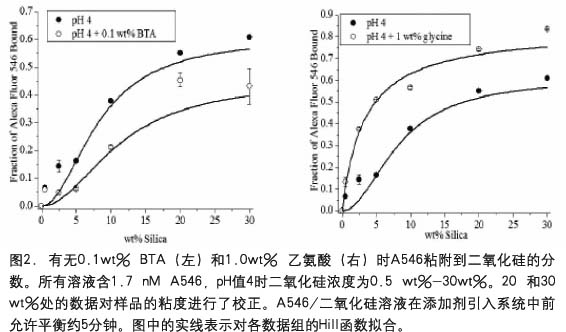
乙氨酸存在时粘附A546分数的增加是料想不到的。数据说明,乙氨酸有利于A546粘附在二氧化硅上。为了确保粘附A546的增加仅仅是由于乙氨酸,研究了离化强度对吸附的影响。因为A546对二氧化硅表面的吸附假定是受静电推动的,因乙氨酸的加入而导致的离化强度变化能改变粒子表面的双电荷层和调停 A546与二氧化硅表面的交互作用。通过用离化强度等价的氯化钠溶液替代5 wt%乙氨酸溶液试验这种可能性。氯化钠既不增加,也不减少粘附A546的浓度。因此,离化强度不是乙氨酸存在时A546吸附增加的原因。以前的文献认为,乙氨酸通过乙氨酸羟基部分与表面硅烷醇根的氢键合与二氧化硅表面相互作用。pH值低时,乙氨酸分子是氢键合在二氧化硅表面,氨基部分将指向本体溶液,使其与A546相互作用。为了查明氨基根指向对A546粘合于二氧化硅粒子浓度的影响,用具有更多空间排列的阻氨基分子(二甲基甘氨酸(DMG))替代测试溶液中的乙氨酸。如图3所示,有二甲基甘氨酸(DMG)存在时,溶液中粘附在二氧化硅上的A546浓度增加,但与有乙氨酸存在时发现的情况不是同一程度。这一发现与乙氨酸分子在二氧化硅表面上的预期指向是一致的。
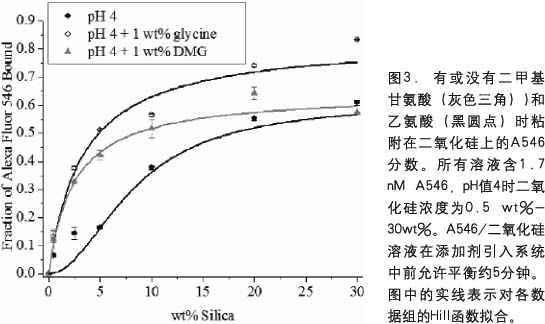
添加剂在常规和高纯二氧化硅上吸附的比较 图4显示了常规(淀析的)二氧化硅和高纯(溶胶与凝胶法的)胶态二氧化硅研磨料对BTA和乙氨酸的吸附的不同。
苯并三唑(BTA)加入含有大小相当的常规(~100nm)和(~120nm)二氧化硅磨料的A546-二氧化硅溶液时, BTA从常规二氧化硅粒子表面取代约20%的粘附A546,如图4(左)所示。在高纯二氧化硅的情况下,没有发现在二氧化硅浓度(0.5至10wt%)范围内A546的吸附是始终如一的。这种BTA的染料替代行为的差别说明,常规和高纯二氧化硅粒子的表面化学过程是不同的。关于乙氨酸添加到二氧化硅磨料弥散液的情况也得到了类似的解释,如图4(右)所示。乙氨酸加入常规二氧化硅分散液将粘合A546的浓度增加约40%。乙氨酸加入高纯二氧化硅的结果是粘合 A546的浓度仅仅增加10%。二氧化硅粒子类型对乙氨酸吸附的明显差别证实了BTA结果的解释,进一步说明,常规和高纯二氧化硅粒子各自的表面化学过程的不同的。

结语 本文显示了在存在BTA和乙氨酸的情况下,FCS作为定量评估用于CMP工艺的二氧化硅磨料常用的CMP添加剂的方法的实用性。二甲基甘氨酸替代乙氨酸使粘合A546增加稍稍低一点,说明乙氨酸的氨基根是指向本体溶液,与溶液中的A546相互作用。根据添加剂在粒子上的吸附,也证明FCS能区分不同类型的二氧化硅磨料,指出了不同二氧化硅磨料粒子的表面化学过程间的差别。