CMP(ChemaclMehcnaacilPosilhing,化学机械抛光)技术,即使用化学和机械方法使抛光物表面达到要求的平整度,它有三个操作步骤:抛光!后清洗和测量"抛光装置如图1.3所示"
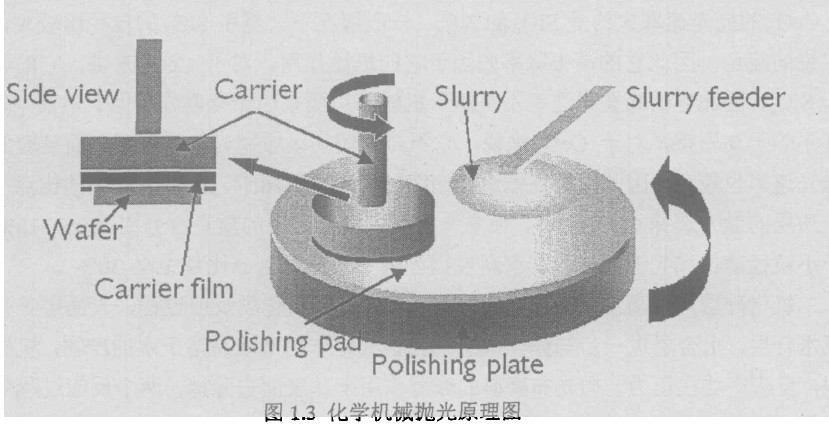
Figl.3SChematiedigaramofhteCMPProcess
工作台在电机的带动下以一定的角速度转动,抛光垫粘在工作台上,硅片吸附在背膜上,背膜在夹持头的带动下,也以一定的角速度转动"同时,机械压力通过夹持头!背膜和抛光液中的磨料将硅片压在浸满抛光液的抛光垫上,在抛光垫的带动下,夹持头!背膜和硅片以相对于抛光垫同样的速率沿与抛光垫相同的方向转动"抛光液以一定的速率流到抛光垫上,在抛光垫的传输和离心力的作用下均匀的分布到抛光垫上,在硅片和抛光垫之间形成一层液体薄膜,这层膜起质量传输和传递压力的作用,液体中的化学成分与硅片产生化学反应,将不溶物质转化为易溶物质(化学反应过程),然后通过机械摩郭权锋:二氧化硅介质层C倒P[抛光液配方研究擦将这些易溶物从硅片表面去掉,溶入流动的液体中带(机械去除过程),这两个过程的结合就可以实现化学机械抛光,使抛光物表面达到平整化的要求"CMP技术所采用的设备及消耗品包括:CMP设备!抛光液!抛光布!后清洗设备!抛光终点检测设备等"其中抛光液和抛光布是消耗品,其余为抛光及辅助设备"CMP工艺过程中的关键要素是抛光液!抛光布和抛光机l[-]"
CMpl艺中应用最广的是ILD层间介质抛光(包括:5102!BpSG!PSG!pol抑ers!Sai从orSiox 姚!Aeorge)sl,510:是最常用的层间介质材料,因此对它的研究也成为目前研究工作的重点e1["因为510:介质中硅是最高价四价,且 510:的化学性质比较稳定,所以不能利用硅片抛光中采用的氧化还原反应方法"目前常用的方法是以510:为磨料的硅溶胶抛光法和以Ceo:为磨料的抛光方法"而510:又分为沉积5102和气相510:两种,通常来讲它们之间的材料去除率关系是:CeO>2沉积510>气相5102,在相同条件下,CeO:的抛光速率大约是510:的3倍"一般情况下,沉积5102的粒径比较大,而且有尖锐的棱角,因此它的高去除率归因于它的机械作用"对于 CeOZ来讲,它的浓度要小于5102,因此它的高抛光速率不是源于机械作用是由于化学作用[zll"然而,高去除率并不等于高平整,对于Ceo:来说, 它不光对较高区域抛光速率较高,而且较低区域的抛光速率也较高,因此它的高低选择比就比较差"但由于它的高去除率的优点,有一些介质层的抛光选择ce02 磨料"通常,磨料在抛光液中的质量百分比是1%一巧%113]"对于小粒径磨粒抛光液来说,其磨料在抛光液中的质量百分比是10%一30%"二氧化硅层间介质层CMP可分为两个基本过程"化学反应过程,表面层首先水解形成水合层,水合层进一步与抛光液中的化学成分作用形成易溶于水的产物;机械作用过程,反应产物在压力!抛光布磨料的摩擦作用下从表面去除掉,两个反应过程中较慢的过程决定最终的抛光速率"试验数据表明,后者速率一般低于前者,由它决定抛光的速率"并且抛光中材料去除速率较高时,表面平整度与完美性均较好"因此如何提高反应产物去除速率成为提高抛光速率的重点"目前,有关ILDCMP技术应用的公司主要集中在日本和欧美地区,如:日本不二见株式会社,美国Cobat,Rdoel等公司他们的抛光检测设备!抛光液的质量(分散性!流动性)都比较好,但是在抛光液研制方面也存在一些问题:对介质膜进行抛光时,这些公司大多采用大粒径磨料(130nnl左右)来提高抛光过程中的机械作用,以此提高抛光
速率,进而提高生产效率"但是这种方法也同时产生了表面划伤严重!抛光液分散性差!金属离子沾污等问题,已很难满足下一代cI制造的要求3[]"而在0.351m以下的cI产大连理工大学硕士研究生学位论文品中,CMP又是必须使用的技术"如何既提高生产效率又提高抛光质量成为CMP技术早日实现规模化应用的关键,也是整个半导体芯片行业亚待解决的问题"
化学机械抛光CMP技术,最初是由mM公司于80年代中期开发出的新技术,1988年SEMATECH财团开始将CMP工艺用于BIM的4MDRAM工艺"几乎所有的半导体制造技术都是由大学或国防研究实验室开发出,然后这种技术便顺利而迅速地进入工业化生产"然而,CMP技术却不同,该技术是由一些主要半导体器件和设备制造厂家们通力合作开发出的"CMP的研究开发工作过去主要集中在美国的SEMAJ毛CH,BIM等公司,现在已在全球范围内展开" 如:欧洲联合EJSSI,法国研究公司LETI和CNET,德国Fruahnoefr研究所等都开始了在该领域的研究3l[]"日本及亚洲的许多国家和地区也制定了研究开发计划"从发展趋势来看,研究正从居主导地位的半导体大公司厂家的工艺开发研究室扩展到设备和材料供应厂家的生产发展研究室"总之,cMP己经成为世界性的研究课题3[]"根据美国助erdoTechnofogies统计1990一1994年间有关CMP的技术在美国以惊人的速度增加,1994年就有150篇CMP专利论文发表"CMP的可贵之处在于它在多层金属互联结构中既可对绝缘体又可对导体进行全局平坦化"目前,其应用范围已从层间介质(IDL)CMp扩展到镶嵌WCMp!镶嵌AICMp!多晶硅CMP!硅氧化物沟道(S功CMP及镶嵌CuCMP等"尽管如此,目前人们对 CMP技术的了解还在定性阶段,还缺少有关定量方面的研究数据"因此,定量确定最佳CMP工艺,系统地研究CMP工艺过程参数,建立完善的CMP理论模型,满足各种超大规模集成电路生产对CMP工艺的不同需求,是CMP技术研究的主要方向"随着计算机!通信及网络技术的高速发展,对作为其基础的集成电路的性能要求也愈来愈高,集成电路芯片增大而单个晶体管元件减小及多层集成电路芯片是发展的必然趋势,这对cMP技术提出了更高的要求111]"在CMP设备方面,正在由单头!双头抛光机向多头抛光机发展,结构逐步由旋转运动结构向轨道抛光方法和线形抛光技术方面发展=l.]"在cMP抛光液方面,关键是要开发新型抛光液,能提供高的腐蚀速率,高的平整度,高的选择性和表面均一性,同时还要有利于后续清洗过程,使得磨料粒子不能残留在芯片表面影响集成电路性能"在应用方面,CMP技术己经在陶瓷!磁头!硬磁盘!机械磨具!精密阀门!光学玻璃!金属材料等表面加工领域不断得到重视和应用"郭权锋:二氧化硅介质层C州P[抛光液配方研究
近几年,在国际半导体设备市场上,用于全局平坦化的CMP设备增长最快"相应的增长也发生在CMP辅助设备!材料等基础工业市场"1993年世界CMP设备市场为7010万美元,1994年为8410万美元,比上年增长61%,以后每年几乎都以60%以上的速度增长最近几年的增长情况及未来预测I-,516]见表1.1所示" 表1.1世界CMP设备市场销售额(亿美元)
Tab1.1ThesaleoftheCMPequiPmentofhteworid(ahundredmillion)

在半导体工业中,CMP最早应用于集成电路(lC)制造中衬底硅的粗抛和精抛,大大提高了硅片的抛光精度和抛光速度,从而极大地提高了硅片抛光的质量和生产效率,降低了生产成本"在CI加工中CMP技术的应用是非常频繁的,如用于前道加工工序价notendproeess)中生产元器件,在后道加11序 b(akcendproeess)中用于产生通路!通道!平坦化层间介电膜和封装等等"近几年来,CMP技术已有一些新的应用领域:平面显示器!微机械系统!多晶片模组等等"CMP也可用于生产其它采用类似半导体生产工艺生产的电子元件,如传感器!检测器和光电摄像管的表面加工11-l"